AIPCB浪潮,关注M9材料升级机会
【原报告在线阅读和下载】:20260122【MKList.com】电子行业专题:AIPCB浪潮,关注M9材料升级机会 | 四海读报
【迅雷批量下载】:链接:https://pan.xunlei.com/s/VOXJ23RJHhoECPL5FRrVathfA1 提取码:umqb
【夸克批量下载】:链接:https://pan.quark.cn/s/fe42cc605010 提取码:j4Vv
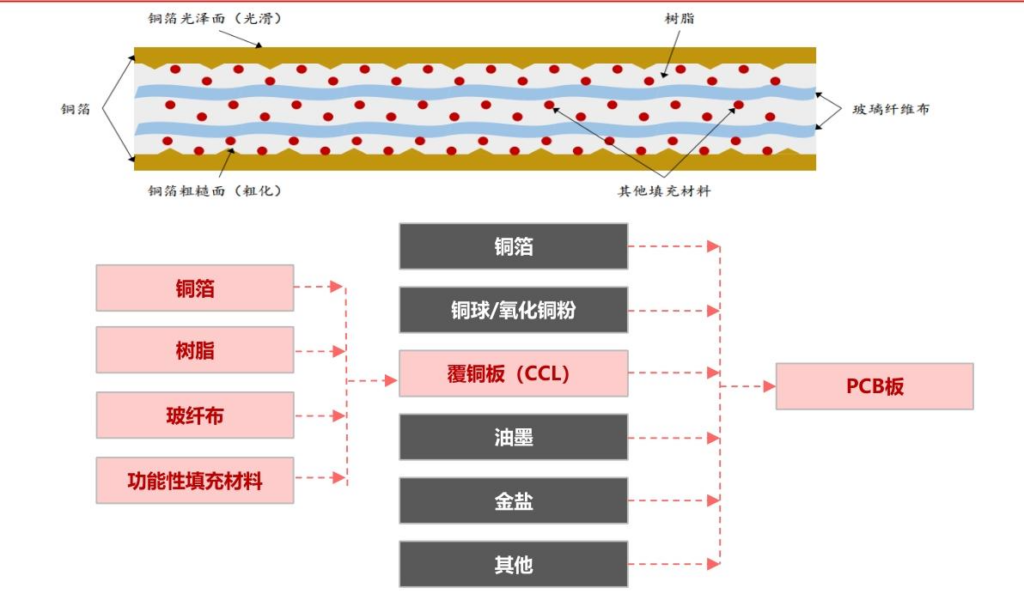
1. 一段话总结
AI浪潮驱动PCB行业迎来量价齐升,M9材料升级成为核心趋势(适配2026年英伟达Rubin平台),AI服务器用高阶覆铜板(CCL)价值量达传统产品的5-7倍,核心围绕电子布、HVLP铜箔、电子树脂、填料四大材料升级,叠加Low Dk电子布、高阶铜箔等高端材料供需紧缺,带动国产替代加速;同时PCB专用电子化学品、电子级氧化铜粉等配套材料同步受益,建议关注各细分领域国产龙头,需警惕行业竞争加剧及需求不及预期风险。
2. 思维导图(mindmap)

3. 详细总结
一、行业核心逻辑:AI驱动CCL升级,M9成关键方向
-
行业景气度核心驱动
- AI服务器需求爆发,带动高阶CCL(覆铜板)需求激增:AI服务器主板层数更多(18-24层)、面积更大,且材料单价更高,使得高阶CCL价值量达传统产品的5-7倍。
- CCL向M9升级:当前M7/M8为高阶AI服务器主流,2026年下半年M9级CCL将量产,适配英伟达Rubin CPX平台及1.6T交换机,材料体系全方位升级。
- 成本结构:CCL成本中,铜箔(42.1%)、树脂(26.1%)、电子布(19.1%)为核心,合计占比超87%。
| CCL核心原材料 | 成本占比 | 核心升级方向 |
|---|---|---|
| 铜箔 | 42.1% | HVLP3→HVLP4→HVLP5 |
| 电子树脂 | 26.1% | 环氧树脂→碳氢树脂(比例2:1) |
| 电子布 | 19.1% | E-glass→NE/NER-glass→Q-glass |
| 填料 | – | 高温氧化法→液相制备法(球形硅微粉) |
二、四大核心材料升级详情
(一)电子布:Q布引领三代升级,供需缺口延续至2027年
- 技术演进:低介电电子布从一代(NE-glass)、二代(NER-glass)向三代(Q-glass)演进,M9级CCL需搭配Q布满足介电性能要求。
- 供需格局:全球低介电电子布日东纺占55%份额,国内宏和科技、泰山玻纤等加速扩产;供给短缺预计延续至2027年下半年,2024年全球需求8000万米,2025年增至1亿米,2033年市场规模达19.4亿美元(CAGR=23.8%)。
- 扩产情况:日东纺2027年一季度投产(产能扩3倍),宏和科技2028年新建产能3135万米,泰山玻纤募投新增5900万米。
(二)HVLP铜箔:HVLP4成2026年主流,高阶产品紧缺
- 技术迭代:从RTF→VLP→HVLP演进,当前HVLP3为主流,2026年HVLP4(粗糙度≤0.5μm)将成为GPU/ASIC AI PCB的主流,正向HVLP5(0.4μm)发展。
- 供需格局:三井金属、金居等主导全球供给,2025年三井月产能620吨,2028年扩至1200吨;国内铜冠铜箔、德福科技、隆扬电子加速突破,HVLP4进入客户测试阶段。
- 行业趋势:高阶铜箔供需缺口显著,加工费上调,产品溢价能力强。
(三)电子树脂:碳氢树脂成M9核心,国产替代加速
- 材料替代:M9级CCL中碳氢树脂与PPO比例提升至2:1,碳氢树脂介电损耗低(0.001-0.005),替代传统环氧树脂。
- 市场格局:海外沙多玛、科腾垄断碳氢树脂供给,国内东材科技2025年产能从500吨扩至3500吨,圣泉集团计划扩产至1000吨/年;PPO领域SABIC占全球50%份额,圣泉集团、同宇新材推进国产化。
(四)填料:球形硅微粉填充率超40%,液相法成主流
- 技术要求:M8/M9级CCL需采用液相法制备球形硅微粉(介电损耗0.0003-0.0006),填充比例逐年提升至40%以上。
- 供需格局:新日铁、龙森等日系企业占70%份额,国内联瑞新材新建3600吨/年液相法产能,2026年全球高速基板用球硅市场规模预计达6.17万吨。
三、其他上游材料:配套升级+国产替代
- 电子级氧化铜粉:占PCB成本6%,适配HDI板、IC载板等高精密电镀需求,江南新材为国内龙头,海外由三菱化学等主导。
- PCB专用电子化学品:水平沉铜技术替代垂直沉铜,安美特等国际巨头垄断高端市场,天承科技、光华科技通过供应商切换推进国产替代。
四、投资建议与风险提示
-
投资标的
材料类别 推荐标的 低介电电子布 宏和科技、菲利华、中材科技 HVLP铜箔 铜冠铜箔、德福科技、隆扬电子 电子树脂 东材科技、圣泉集团、宏昌电子、同宇新材 填料 联瑞新材 电子级氧化铜粉 江南新材 PCB专用电子化学品 天承科技 -
风险提示
- 行业竞争加剧风险;
- 下游AI服务器需求不及预期;
- 行业扩产速度超需求,导致价格下跌;
- 海外技术封锁或供应链扰动。
4. 关键问题及答案
问题1:M9级CCL材料升级的核心变化是什么?对上游材料提出了哪些新要求?
- 答案:M9级CCL是适配2026年英伟达Rubin平台及1.6T交换机的最高级别覆铜板,核心变化是材料体系全方位升级,以满足更低介电损耗(Df≤0.0010)和更高信号传输速度需求。对上游材料的新要求:①电子布:需采用第三代Q-glass(介电常数4.5),替代现有NE/NER-glass;②HVLP铜箔:需升级至HVLP4(粗糙度≤0.5μm),保障信号完整性;③电子树脂:碳氢树脂与PPO比例提升至2:1,替代传统环氧树脂;④填料:需采用液相法球形硅微粉,填充率超40%,降低介电损耗。
问题2:当前AI PCB上游高端材料的供需格局如何?国产替代进展怎样?
- 答案:供需格局:①高端材料普遍紧缺,Low Dk电子布、HVLP4铜箔、碳氢树脂等产能缺口预计延续至2027年;②海外企业主导高端市场,电子布日东纺占55%份额,碳氢树脂由沙多玛、科腾垄断,球形硅微粉日系企业占70%。国产替代进展:①电子布:宏和科技、泰山玻纤加速扩产,2027年产能陆续释放;②HVLP铜箔:铜冠铜箔HVLP4进入客户测试,隆扬电子HVLP5工厂建成;③电子树脂:东材科技、圣泉集团扩产碳氢树脂,打破海外垄断;④填料:联瑞新材掌握液相法技术,新建产能填补缺口,国产替代加速推进。
问题3:AI驱动下,PCB上游材料的投资机会集中在哪些领域?核心逻辑是什么?
- 答案:投资机会集中在四大核心材料+两大配套材料,核心逻辑是“升级驱动价值量提升+供需紧缺+国产替代”。①低介电电子布:Q布需求2026年放量,国内企业扩产卡位;②HVLP铜箔:HVLP4成主流,高阶产品紧缺且加工费上涨;③电子树脂:碳氢树脂用量占比提升,国产产能释放;④球形硅微粉:液相法技术突破,填充率提升带动需求;⑤电子级氧化铜粉:适配高阶PCB电镀需求,国产龙头垄断国内市场;⑥PCB专用电子化学品:水平沉铜技术替代,国产企业通过供应商切换实现突破。
© 版权声明
免费分享是一种美德,知识的价值在于传播;
本站发布的图文只为交流分享,源自网络的图片与文字内容,其版权归原作者及网站所有。
THE END
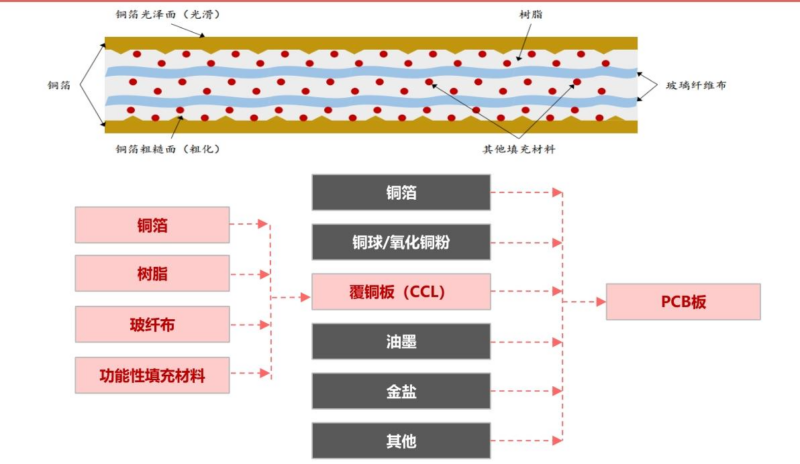















暂无评论内容