混合键合设备:AI算力时代的芯片互连革命与BESI的领航之路
【原报告在线阅读和下载】:20260126【MKList.com】半导体行业分析手册之二:混合键合设备:AI算力时代的芯片互连革命与BESI的领航之路 | 四海读报
【迅雷批量下载】:链接:https://pan.xunlei.com/s/VOXJ23RJHhoECPL5FRrVathfA1 提取码:umqb
【夸克批量下载】:链接:https://pan.quark.cn/s/fe42cc605010 提取码:j4Vv
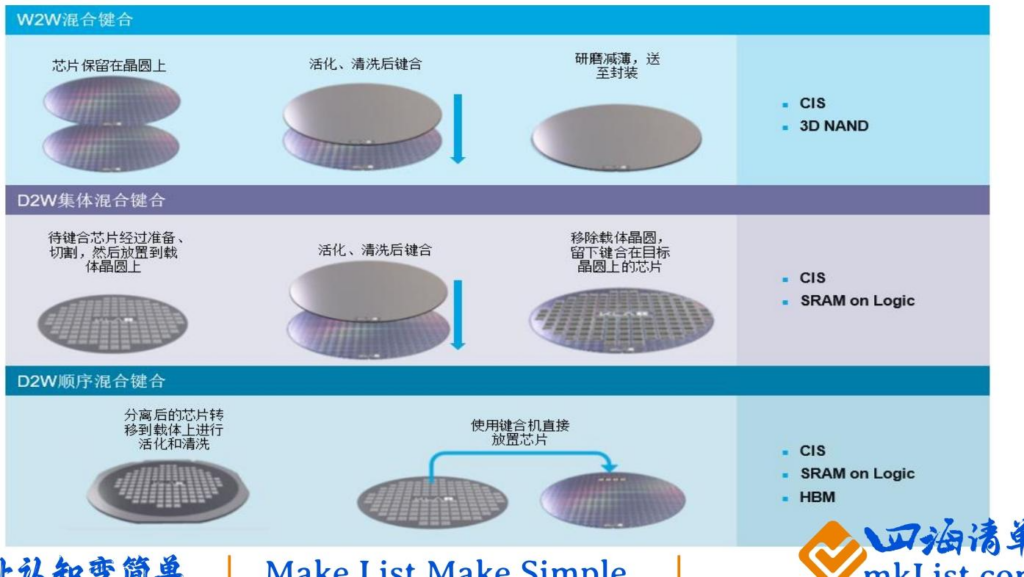
1. 一段话总结
混合键合(Hybrid Bonding) 作为后摩尔时代突破算力瓶颈的关键使能技术,通过铜-铜直接键合实现10μm以下超精细间距互连,在互连密度、带宽等性能上实现数量级提升,已成熟应用于3D NAND、CIS领域,并加速向HBM5、AI芯片、SoIC等高性能场景渗透;全球市场由荷兰BESI主导(市占率约70%),国产厂商拓荆科技、迈为股份、百傲化学实现零到一突破并进入产业化验证;受益于AI/HPC与HBM的爆发式需求,2030年全球混合键合设备累计安装量预计达960-2000台,市场规模超6亿美元,国产替代机遇明确,需警惕技术导入及地缘政治风险。
2. 思维导图(mindmap)
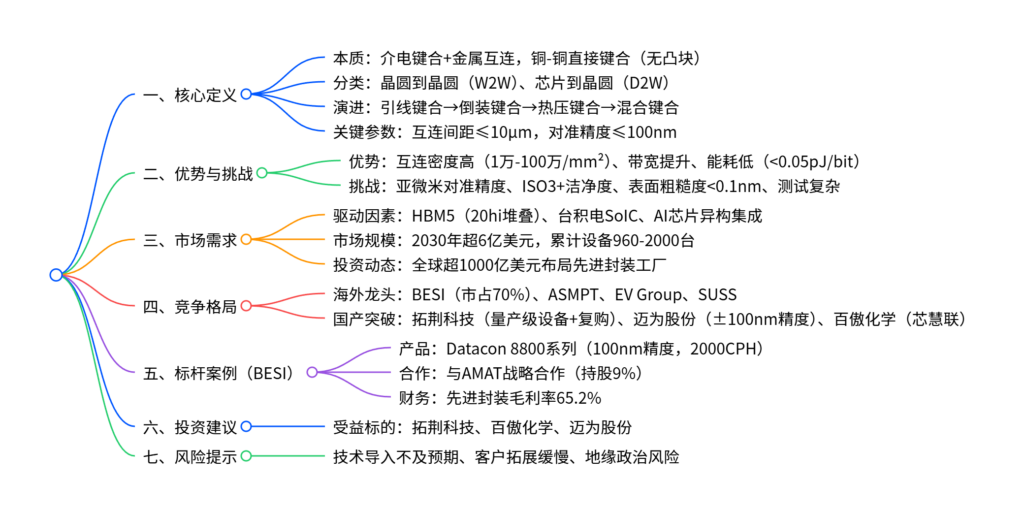
3. 详细总结
一、混合键合:后摩尔时代的互连革命
-
技术本质与演进
-
定义:结合介电键合(SiO₂)与金属互连(Cu),通过无凸块铜-铜直接键合实现晶圆/芯片间高密度互连,互连间距≤10μm时优先采用。
-
演进历程:从1975年引线键合(间距20-10μm),逐步迭代至混合键合(间距0.1-0.5μm),互连密度提升千倍以上。
-
分类及适用场景:
类型 核心特点 适用场景 良率/成本优势 W2W(晶圆到晶圆) 对准精度高、吞吐量高 3D NAND、CIS 芯片尺寸相同时成本更低 D2W(芯片到晶圆) 筛选优质芯片、支持异构集成 HBM、AI芯片 缺陷率低,适配不同工艺芯片
-
-
核心性能优势
- 极致互连密度:单位面积I/O接点数量达1万-100万/mm²,较传统凸块键合(25-400/mm²)提升显著。
- 性能突破:信号传输延迟降低,单位比特能耗<0.05pJ/bit,较倒装键合(0.5pJ/bit)优化90%。
- 工艺兼容性:可与TSV、微凸块等技术结合,支持逻辑、存储、传感器异构集成。
二、行业需求:AI与先进封装驱动爆发
-
核心应用场景落地
- HBM领域:HBM5(20hi堆叠)受限于模块高度(775μm),微凸块技术(14.5μm高度)无法满足,三星、美光、SK海力士均确定采用混合键合。
- 逻辑集成:台积电SoIC技术依赖混合键合实现超高密度异构集成,2025年产量翻番至1万片,2026年计划再翻倍。
- 存储领域:3D NAND已成熟应用W2W混合键合,CIS领域替代TSV互连,实现成本与占位面积优化。
-
市场规模与投资动态
- 市场预测:全球混合键合设备市场2030年规模超6亿美元,亚太地区占比超68%,中国市场有望超4亿美元。
- 设备需求:2030年全球累计安装量预计960-2000台,逻辑芯片、HBM、共封装光学是核心需求来源。
- 产业投资:全球超1000亿美元规划先进封装工厂,台积电、三星、Intel等大厂加速扩产。
三、竞争格局:海外主导,国产突破
-
海外龙头格局
- BESI(荷兰):绝对龙头,2024年市占率约70%,旗舰产品Datacon 8800 CHAMEO ultra plus AC实现100nm对准精度、2000CPH吞吐量,累计订单超100套,客户覆盖台积电、三星等。
- 其他海外厂商:ASMPT(2024年交付首台混合键合设备)、EV Group(D2W领域领先)、SUSS(XBS300平台精度100nm)。
-
国产厂商进展
企业 核心产品 关键进展 性能指标 拓荆科技 Dione 300(W2W)、Pollux(预处理) 国产首台量产级设备,获复购订单 性能达国际领先水平 迈为股份 MX-11D1(W2W/D2W) 批量交付,进入龙头客户打样 对准精度±100nm,目标±50nm 百傲化学(芯慧联) SIRIUS RT300(D2W)、CANOPUS RT300(W2W) 2台设备出货,产业化验证 精度达国际先进水准 艾科瑞思 麒芯8800(D2W) 键合精度500nm 支持2.5D/3D封装
四、标杆案例:BESI的领航之路
-
核心竞争力
- 产品布局:覆盖从2D封装到2.5D/3D集成的全设备组合,混合键合设备精度计划2025年底突破50nm。
- 生态合作:与应用材料(AMAT)战略合作,AMAT持股9%成为最大股东,联合开发全集成解决方案。
- 财务表现:2024年营业收入6.075亿欧元(同比+4.9%),先进封装业务毛利率65.2%,AI相关计算应用订单快速增长。
-
订单趋势:2025Q3新增订单环比+36.5%,同比+15.1%,主要来自亚洲封测厂的2.5D数据中心、光子学及AI计算应用需求。
五、投资建议与风险提示
-
投资建议:混合键合是AI算力时代的核心使能技术,需求由HBM与先进封装爆发驱动,国产替代机遇明确,推荐标的:
- 拓荆科技(国产混合键合设备领军,获大基金三期注资);
- 百傲化学(芯慧联布局W2W/D2W设备,半导体业务快速增长);
- 迈为股份(磨划+键合整体解决方案,设备批量交付)。
-
风险提示
- 技术风险:亚微米对准、洁净度控制等技术难点导致导入不及预期;
- 市场风险:下游AI芯片、HBM需求放缓,设备采购延迟;
- 外部风险:地缘政治影响设备出口与技术合作。
4. 关键问题及答案
问题1:混合键合技术的核心价值是什么?相比传统键合技术,其突破了哪些性能瓶颈?
- 答案:核心价值是通过无凸块铜-铜直接键合,实现后摩尔时代芯片异构集成的高密度、高性能互连,为AI芯片、HBM等算力核心部件突破物理极限提供支撑。相比传统技术,其突破的瓶颈包括:①互连密度,从传统键合的25-400个/mm²提升至1万-100万个/mm²,单位面积I/O接点数量提升千倍;②传输性能,信号路径缩短,带宽大幅提升,单位比特能耗从0.5pJ/bit降至<0.05pJ/bit;③集成灵活性,支持逻辑、存储、传感器等不同工艺芯片的3D堆叠,适配Chiplet架构发展。
问题2:混合键合设备的市场需求主要来自哪些领域?2030年市场规模及设备需求的核心预测依据是什么?
- 答案:核心需求领域包括三大类:①逻辑芯片(AMD、Intel、博通的高端AI芯片);②存储及共封装光学(HBM4/5、3D NAND、共封装光学器件);③新兴应用(智能眼镜、微型显示器、传感器)。2030年市场规模超6亿美元、设备累计960-2000台的预测依据:①HBM5(20hi堆叠)强制采用混合键合,2026年HBM4e 16hi产品量产;②台积电SoIC产能2026年翻倍,带动设备需求;③全球超1000亿美元先进封装工厂投资落地;④逻辑芯片、共封装光学等新场景需求释放,行业进入规模化量产阶段。
问题3:国产混合键合设备厂商的突破点在哪里?与海外龙头BESI相比,国产厂商的竞争优势与差距是什么?
- 答案:国产厂商的核心突破点是实现从0到1的技术落地,拓荆科技推出国产首台量产级设备并获复购,迈为股份、百傲化学设备进入产业化验证,打破海外垄断。竞争优势:①成本优势,综合成本低于海外设备;②本土化服务,适配国内封测厂工艺需求;③政策支持,大基金三期重点投资,产业链协同效应显著。差距:①精度与稳定性,BESI设备精度达100nm,国产当前多在±100nm-500nm区间,需进一步优化;②客户资源,BESI绑定全球头部晶圆厂,国产客户仍以国内厂商为主;③生态成熟度,BESI与AMAT战略合作,国产厂商生态合作尚处于起步阶段。
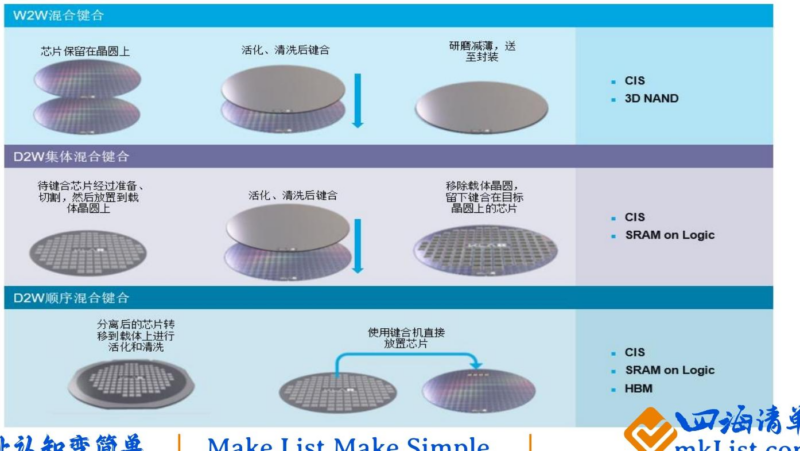

















暂无评论内容